Hauptinhalt
Rasterkraftmikroskopie (AFM)
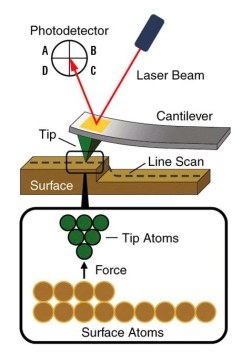
Rasterkraftmikroskopie wird in verschiedenen Messmodi betrieben, von denen hier eine Auswahl präsentiert wird:
Contact-AFM
In diesem Modus wird eine sehr feine Spitze, die sich an einer Feder (Cantilever, Bild oben rechts) befindet, über die Oberfläche gerastert. Die dabei auftretenden Kräfte sorgen dafür, dass der Cantilever sich verbiegt. Ein Laser, der auf den Cantilever gerichtet ist, erfährt eine Auslenkung, die von einer 4-Quadrant-Photodiode detektiert wird (oben links). So entsteht, Linie für Linie, ein topographisches Bild der Oberfläche.
Tapping-AFM
Da im Contact-Mode eine dünne organische Schicht beschädigt werden kann, benutzt man für diese Art Proben einen Modus, bei dem der Cantilever nahe seiner Resonanzfrequenz zu einer Schwingung angeregt wird. Insgesamt wird weniger Energie in der Probe deponiert und die laterale Auflösung ist im Vergleich zum Contact-Mode erhöht. Hier bieten sich zwei Möglichkeiten: Zum einen kann der Cantilever über Piezoelememte angeregt werden (AC-Mode), zum anderen über ein magnetisches Wechselfeld (Top-MAC-Mode, Spule in dafür vorgesehenem Nosecone, magnetisierbare Cantilever notwendig, Messungen in Lösung möglich).
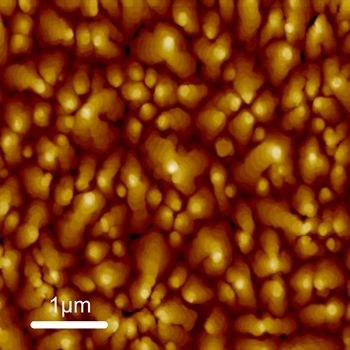
Beispielhafte Aufnahme im Top-MAC-Mode: Pentacen auf Si-Wafer, monomolekulare Stufen sind erkennbar.

Beispiel AC-Mode: Oberfläche eines Perylen-Kristalls mit monomolekularen Stufen.
Dynamic Lateral Friction Microscopy
In diesem Modus wird der Cantilever in lateraler Richtung, also parallel zur Probenoberfläche, zur Schwingung angeregt. Gibt es auf der Probenoberfläche Bereiche mit unterschiedlichen Reibungseigenschaften, wird die Schwingung dort unterschiedlich stark gedämpft. In der Aufnahme der gedämpften Amplitude ergibt sich also ein Kontrast bezüglich der Energiedissipation.

Beispiel DLFM: Pentacen-Submonolage auf SiO2. Links: Topographie mit einheitlicher Höhe der Inseln; Mitte: DLFM-Amplitude mit Kontrast zwischen relativ zueinander verdrehten Pentacen-Domänen; man beachte die Domänengrenzen. Rechts: Schema der Struktur einer Pentacen-Monolage auf SiO2. Die Reibungseigenschaften unterscheiden sich in a- und b-Richtung, was zur Ausbildung des gezeigten DLFM-Kontrasts führt.
Current Sensing
Zwischen Probe und Spitze kann eine Spannung angelegt werden. So kann im Contact-Mode zusätzlich zur Topographie der elektrische Strom abgebildet werden.

Beispiel Current Sensing: Kratzer in einer polykristallinen Au-Schicht auf Si.
In unserer Arbeitsgruppe steht für diese Messungen ein Agilent 5500 SPM für Messungen in Atmosphären- oder kontrollierter Gasumgebung zur Verfügung, darüber hinaus ein in ein UHV-System integriertes Mikroskop.